Dow 電子材料
針對細間距錫焊凸塊應用的SOLDERON™ BP TS 6000錫-銀電鍍液
針對當今的細間距錫焊凸點電鍍工藝,諸如在2.5D和3D的IC封裝技術中所使用的銅柱和微凸塊,SOLDERONTM BP TS 6000錫-銀電鍍液是一種可優化工藝的、高性能的無鉛的替代產品。其新一代的配方技術為覆晶片封裝和互連工藝(圖-1)提供了業界領先的電鍍速率和最大程度上的工藝靈活性。新一代電鍍液的特點是提高了錫銀電鍍工藝的性能及電鍍液的穩定性,而且使用更方便,從而實現了業界最廣泛的工藝範圍,且具有很強的工藝靈活性,其擁有成本(COO)亦極具競爭力。
此電鍍液的電鍍速率範圍即可從2微米/分鐘到9微米/分鐘。該電鍍液可由配方調整銀組成,這就使其適用于諸多應用領域,而不用改變電鍍液配方以應對不同的加工要求。該電鍍液的穩健性足以應對多種電路設計的晶圓凸塊和蓋封工藝,而且該產品並不限於特定的光阻劑(圖-2)。在範圍寬廣的諸多晶圓類型中,使用TS6000電鍍的凸塊在迴焊後,芯片內凸塊均勻性(WID)小於5%, 證明其可適用於大規模生產(圖-3)。此外,在迴焊之後無大孔洞和微孔洞產生,從而提高了良率及可靠性(圖-4和圖-5)。
SOLDERON BP TS 6000錫-銀電鍍液已被證實在電解和熱性能方面均具有優異的穩定性。其電解壽命>100 Ah/L,使用時間超過6個月,並可兼容線上濃度分析,從而使鍍液更方便使用。
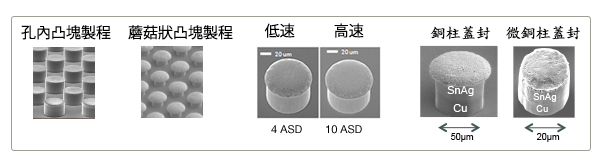
圖—1: SOLDERON BP TS 6000錫-銀電鍍液在眾多應用領域、工藝條件和電鍍速率中廣泛的工藝範圍的示例。

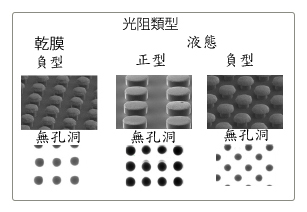
圖—2: SOLDERON BP TS 6000錫-銀電鍍液在乾膜和液態光阻上均表現出穩定的性能,沒有孔洞。

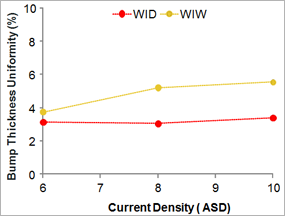
- 縱坐標:WID均勻性(%)
- 橫坐標:電流密度(ASD)
- 6-10ASD時的WID均勻性<5%
- 6-10ASD時的WIW均勻性<10%
圖—3: SOLDERON BP TS 6000錫-銀電鍍液的WID和WIW均勻性證明其在大規模生產方面的適用性。

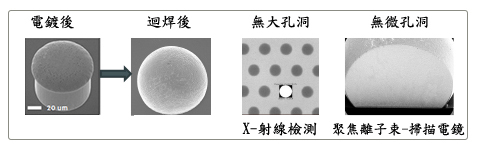
圖—4: 在與陶氏的和其他主要的銅(Cu)柱電鍍產品配合使用時,
SOLDERON BP TS 6000錫-銀電鍍液的均勻性更佳,表面形貌更加平滑,而且連接界面更加平整、無孔洞。

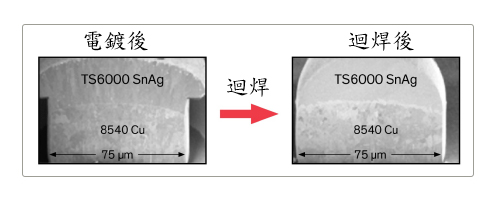
圖—5: 在銅柱蓋封應用中,SOLDERON BP TS 6000錫-銀電鍍液在迴焊後形成一種平整、沒有微孔洞的連接界面。


