Dow 전자 재료
미세 피치 솔더 범프 응용 분야를 위한 SOLDERON™ BP TS 6000 틴실버(SnAg) 도금 약품
SOLDERONTM BP TS 6000 틴실버(SnAg) 도금 약품은 2.5D 및 3D IC 패키징 기술에 사용되는 카파 필라(Cu Pillar) 및 마이크로 범프와 같은 오늘날의 미세 피치 솔더 범프 도금 응용 분야에 최적화된 고성능 무연 대체재이다. 이 차세대 포뮬레이션은 플립 칩 패키지 및 인터커넥트를 위한 업계 최고 수준의 도금 속도 및 공정 유연성을 가능케 한다. (그림 1) 이 새로운 약품은 도금 성능, 도금욕 안정성 및 사용 편의성을 향상시킴으로써 뛰어난 공정 유연성과 소유 비용(Cost Of Ownership, COO) 최소화를 통해 업계에서 가장 넓은 공정 구간(process window)을 구현할 수 있다.
이 단일 포뮬레이션은 분당 2 ~ 9+ um 속도로 도금이 가능하다. 또한 이 포뮬레이션의 Ag 성분의 가변 특성으로 여러 응용 분야에 적용이 가능하고, 다양한 공정 요건에 따른 약품 변경의 필요가 적다. 이 약품은 광범위한 패턴 웨이퍼의 범핑 및 캡핑 모두에 대해 뛰어난 성능을 보이며, 특정 포토레지스트에만 사용이 국한되지도 않는다. (그림 2) 이 약품은 광범위한 웨이퍼 유형에 대해 리플로우(reflow) 후, 5% 미만의 WID(With-In Die) 범프 두께 균일성을 보이며, 이는 대량 생산에 적합하다는 것을 입증하는 것이다. (그림 3) 또한 이 약품은 리플로우(reflow) 후 매크로 보이드(macro-void)와 마이크로 보이드 (micro-void)가 발생하지 않아 생산성 및 신뢰성 향상에 기여한다. (그림 4 및 5)
SOLDERON BP TS 6000 틴실버(SnAg) 도금욕(plating bath)은 전기분해적 측면과 열에 대한 높은 안정성을 지니고 있음이 입증되었다. 100Ah/L이상의 전해 도금액 수명과 6개월 이상의 도금욕 사용기간은 규격화 된 인라인 공정에서 사용 편의성과 관련하여서도 손색이 없다.

그림 1. 광범위한 응용 분야, 공정 조건 및 도금 속도 관련 SOLDERON BP TS 6000 틴실버(SnAg)의 넓은 공정 구간을 보여주는 예

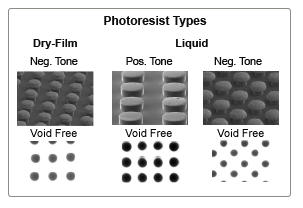
그림 2. SOLDERON BP TS 6000 틴실버(SnAg)는 건식 필름 및 액상 포토레지스트 모두에서 보이드(Void)가 없이 일관된 성능을 보여준다.

두께의 균일성 측면: WID(Within Die) 및 WIW(Within Wafer)
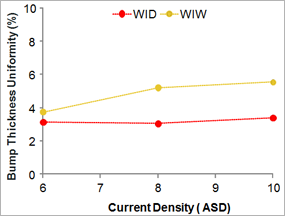
- WID 균일성: 6-10 ASD부터 5% 미만
- WIW 균일성: 6-10 ASD부터 10% 미만
그림 3. SOLDERON BP TS 6000 틴실버(SnAg)의 WID 및 WIW 균일성으로 대량 생산에 적합하다는 것이 입증되었다.

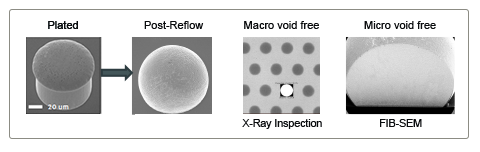
그림 4. SOLDERON BP TS 6000 틴실버(SnAg)를 다우 및 다른 선도 업체의 카파 필라(Cu Pillar) 포뮬레이션과 함께 사용했을 때 매끄럽고 보이드(void)가 없는 인터페이스 외에 균일성 향상은 물론 보다 부드러운 표면 형태를 구현할 수 있다.

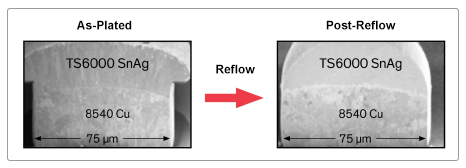
그림 5. SOLDERON BP TS 6000 틴실버(SnAg)는 카파 필라 캡핑 응용 분야에서 리플로우(reflow) 후 마이크로 보이드(micro-void)가 없는 매끄러운 인터페이스를 형성한다.


