Dow 电子材料
針對細間距錫焊凸塊應用的SOLDERON™ BP TS 6000錫-銀電鍍液
针对当今的细间距锡焊凸点电镀工艺,诸如在2.5D和3D的IC封装技术中所使用的铜柱和微凸点,SOLDERONTM BP TS 6000锡-银电镀液是一种可优化工艺的、高性能的无铅的替代产品。其新一代的配方技术为倒装芯片封装和互连工艺(图-1)提供了业界领先的电镀速率和最大程度上的工艺灵活性。新一代电镀液的特点是提高了锡银电镀工艺的性能及电镀液的稳定性,而且使用更方便,从而实现了业界最广泛的工艺范围,且具有很强的工艺灵活性,其拥有成本(COO)亦极具竞争力。
此电镀液的电镀速率范围即可从2微米/分钟到9微米/分钟。该电镀液可使银组分连续可调,这就使其适用于诸多应用领域,而不用改变电镀液配方以应对不同的加工要求。该电镀液的稳健性足以应对多种电路设计的晶圆凸点和盖封工艺,而且该产品并不限于特定的光阻剂(图-2)。在范围宽广的诸多晶圆类型中,使用TS6000电镀的凸点在回流后,芯片内凸点高度均匀性(WID)小于5%, 证明其可适用于大规模生产(图-3)。此外,在回流之后无大孔洞和微孔洞产生,从而提高了良率及可靠性(图-4 和 图-5)。
SOLDERON BP TS 6000锡-银电镀液已被证实在电解和热性能方面均具有优异的稳定性。其电解寿命>100 Ah/L,使用时间超过6个月,并可兼容在线浓度分析,从而使镀液更方便使用。
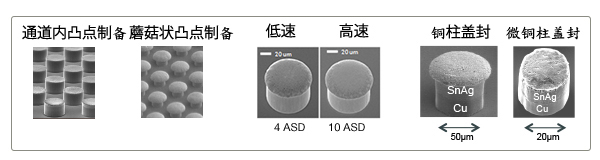
图—1: SOLDERON BP TS 6000锡-银电镀液在众多应用领域、工艺条件和电镀速率中广泛的工艺范围的示例。

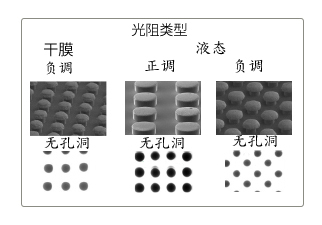
图—2: SOLDERON BP TS 6000锡-银电镀液在干膜和液态光阻上均表现出稳定的性能,没有孔洞。

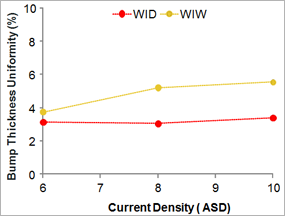
- 纵坐标:凸点高度均匀性(%)
- 横坐标:电流密度(ASD)
- 6-10ASD时的WID均匀性<5%
- 6-10ASD时的WIW均匀性<10%
图—3: SOLDERON BP TS 6000锡-银电镀液的WID和WIW均匀性证明其在大规模生产方面的适用性。

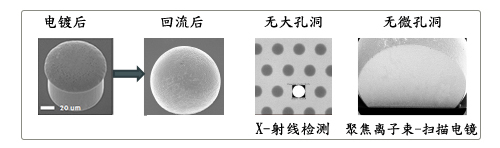
图—4: 在与陶氏的和其他主要的铜(Cu)柱电镀产品配合使用时,SOLDERON BP TS 6000锡-银电镀液的均匀性更佳,表面形貌更加平滑,而且连接界面更加平整、无孔洞。

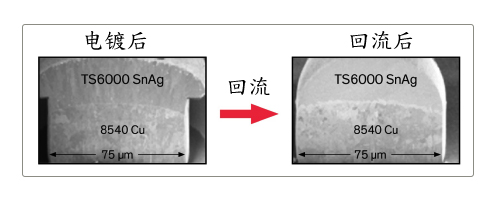
图—5: 在铜柱盖封应用中,SOLDERON BP TS 6000锡-银电镀液在回流后形成一种平整、没有微孔洞的连接界面。


